9.13 Инжекционный лазер.

Рис. 9.12
В инжекционных лазерах используется p-n переход, образованный вырожденными полупроводниками с разным типом проводимости. На рис. 9.12, а показана энергетическая диаграмма такого p-n перехода в состоянии равновесия, т. е. при отсутствии внешнего напряжения, а следовательно, и тока через переход. Уровни Ферми x Fn и x Fp в обеих областях совпадают. Приближенно можно считать, что в n-области электроны проводимости располагаются на уровнях между “дном” зоны проводимости x пр и уровнем Ферми x Fn, а в p-области дырки – между “потолком” валентной зоны x в и уровнем Ферми x Fn. Энергетическая диаграммы для случая, когда к p-n переходу приложено прямое напряжение U0, показано на рисунке 9.12 б. Понижение потенциального барьера на величину U0 увеличивает поток электронов из n-области и поток дырок из p-области через переход. Через p-n переход течет ток, и вблизи перехода установится некоторое распределение концентрации неравновесных носителей заряда.
Известно, что при неравновесном состоянии теряет смысл понятие уровня Ферми. Однако для определения полной концентрации носителей в неравновесном состоянии можно воспользоваться прежними формулами, если вместо уровней Ферми ввести квазиуровни Ферми для электронов и дырок. Вдали от перехода (рис. 9.12, б), где сохраняется равновесное состояние, применимы обычные уровни Ферми x Fn и x Fp. В области перехода, где имеются неравновесные носители, существуют два квазиуровня Ферми – для электронов x ’Fn и для дырок x ’Fp. Обычно предполагают, что в пределах перехода до пересечения линии x Fn с границей зоны проводимости величины x Fn и x ’Fn мало отличаются.
Аналогичное предположение дают и для уровней x Fp и x ’Fp. Далее кривая квазиуровня электронов x ’Fn опускается и сливается с уровнем Ферми x Fp. Соответственно, кривая квазиуровня для дырок x ’Fp поднимается и сливается с уровнем Ферми x Fn.
В некоторой области перехода с шириной d одновременно велико число электронов проводимости в группе уровней D x пр и дырок в группе уровней D x в. Поэтому в области d распределение носителей зарядов подобно распределению их на рисунке 9.12, и в ней можно получить инверсию населенностей. В этой области перехода наблюдается наиболее интенсивная рекомбинация электронов и дырок, так как скорость рекомбинации пропорциональна произведению концентраций электронов и дырок, а они в рассматриваемой области велики. Рекомбинация электронов и дырок в переходе сопровождается спонтанным излучением с энергии, большей ширины запрещенной зоны hn > D x 0.
С увеличением внешнего напряжения U0 растут концентрации электронов и дырок в области d перехода, увеличивается инверсия населенности. При некотором пороговом напряжении, когда вынужденное излучение, вызванное спонтанным излучением, достаточно для компенсации потерь света в материале полупроводника и в отражающих поверхностях, наступит генерация. Таким образом, p-n переход при малых токах является источником спонтанного (рекомбинационного) излучения (светодиод), а при токах более порогового – источником когерентного излучения (лазер).
Пороговый ток сильно зависит от температуры и концентрации примесей. Понижение температуры облегчает вырождение полупроводника и, следовательно, уменьшает пороговый ток. Лазеры на арсениде галлия работают при температуре жидкого гелия 4,2 К или жидкого азота 77 К. В настоящее время появились инжекционные лазеры, работающие при комнатной температуре. Экспериментально установлено, что измерение температуры от 4,2 К до комнатной может привести к увеличению плотности порогового тока до 100 раз. При комнатной температуре необходима плотность порогового тока 105 А/см2.
Распространение получил инжекционный лазер на основе вырожденного арсенида галлия GaAs, конструкция которого показана на рисунке 9.13. Две грани полупроводника перпендикулярны плоскости p-n перехода, чтобы не создавать в этом направлении условий для самовозбуждения. Размеры сторон полупроводника – порядка нескольких десятых долей миллиметра. Излучение выходит из узкой области p-n перехода перпендикулярно параллельным граням полупроводника.

Рис. 9.13
Изучение инжекционного лазера имеет большую угловую расходимость вследствие дифракционных явлений в резонаторе. Пусть толщина области p-n перехода, в которой происходит генерация, d = 1 мкм, а расстояние между зеркалами L = 0,1 мм. Тогда число Френеля при l = 1 мкм N = 10-2. При таком малом числе Френеля потери велики, а угловая расходимость составляет 5-6 градусов. Однако в другой плоскости (плоскости p-n перехода) угловая расходимость меньше
(примерно 1 градус), т. к область излучения здесь примерно на порядок больше.
Спектр излучения инжекционного лазера зависит от выходной мощности, которая, в свою очередь, определяется плотностью тока через р-n переход. Когда плотность тока незначительно превышает пороговую плотность тока, имеется только одна мода с шириной линии излучения около 0.5 А, и длинной волны λ=0.84 мкм (8400А),
Соответствующий ИК-диапазону. С ростом плотности тока число мод увеличивается. Частота генерируемых мод зависит от температуры, так как последняя влияет на коэффициент преломления кристалла и ширину запрещенной зоны. При измерении температуры возможен перескок от одной моды к другой. Поэтому долговременная стабильность частоты оказывается гораздо меньше, чем у газовых лазеров. Следует отметить, что излучение инжекционных лазеров поляризовано.
Обычно инжекционные лазеры работают в импульсном режиме, при этом максимальная мощность в импульсе ограничивается перегревом кристалла и зависит от рабочей температуры, и длительности импульса. Наибольшая импульсная мощность при температуре жидкого азота в лазерах на GaAs составила 100 Вт, при длительности импульсов примерно несколько микросекунд и частоте следования до 10 кГц. Основным достоинством инжекционных лазеров является возможность модуляции излучения изменением напряжения на p-n переходе.
Коэффициент полезного действия инжекционных лазеров ограничивается в основном следующими причинами. Во-первых ,часть электронов, двигающихся в p-n переходе вследствие большой длинны свободного пробега проходит активную область, не участвуя в создании вынужденного излучения. Во-вторых, генерируемое световое излучение распространяется не только в активной области, но и рядом с ней, где отсутствует инверсия населённости, и, следовательно, происходит поглощение излучения. Кроме этих причин имеется потеря мощности источника питания, связанная с прохождением тока, через области и контакты. Поэтому КПД инжекционных лазеров, на основе GaAs обычно составляет несколько процентов, хотя при оптимальных условиях может достигать десятки процентов.
Советскими учёными Ж. И. Алфёровым и другими предложены инжекционные лазеры на основе гетеропереходов (гетеролазеры), имеющие высокий КПД. В этих лазерах используют полупроводниковые материалы, с различной шириной запрещённой зоны.
Полупроводниковая структура гетеролазеров (рис. 9.14, а) состоит из области GaAs n-типа, узкой областью GaAs p-типа, области тройного соединения AlxGa1-xAs p-типа. Активной является средняя область, где создается инверсия населённости. На границе средней и правой области создаётся потенциальный барьер, который ограничивает длину свободного пробега электронов, инжектируемых из левой области, и повышает эффективность образования вынужденного излучения.
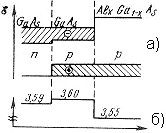
Рис. 9.14
Кроме этого, одновременно уменьшается поглощение света в правой неактивной области, так как из-за различия в коэффициентах преломления в средней и правой областях (рис.9.14, б) наблюдается полное внутреннее отражение света на их границе (волноводный эффект). В СССР разработаны гетеролазеры, с полным внутренним отражением света с обеих сторон от активного слоя, лазеры с двойной гетероструктурой, или ДГС-лазеры. В этих лазерах удалось существенно понизить плотность порогового тока, и получить большой КПД, что позволило при комнатной температуре осуществить режим непрерывного излучения, который был ранее возможен ,только при температуре жидкого азота. В ДГС-лазерах, на основе GаAlAs при комнатной температуре получена плотность порогового тока не менее 1кА/см2.Отличительными особенностями гетеролазеров является высокий КПД, удобство возбуждения, малые габариты. Путём изменения концентрации примесного алюминия от 0 до 30 % в AlxGa1-xAs можно изготовлять лазеры с различной длинной волны излучения в пределах 0,9-0,68 мкм. Преимущества полупроводниковых лазеров заключается в простоте модуляции излучения, осуществляемого изменением тока накачки.
Недостаток полупроводниковых лазеров – невысокая степень когерентности излучения, плохая температурная и радиационная устойчивость и пока ещё низкая долговечность: так, в лабораторных условиях получена долговечность 104 ч., однако в промышленных образцах она на порядок ниже.
Крупным достижением лазерной техники последних лет явилось создания гетеролазера с распределённой обратной связью. В таком полупроводниковом лазере торцевые зеркальные поверхности , образующие оптический резонатор, заменены дифракционной решеткой, которая, как известно на определённых частотах полностью отражает падающее на неё излучение.
Повышение мощности излучения инжекционных лазеров добиваются изготовлением набора (решёток) лазерных диодов. Например, при комнатной температуре получена импульсная мощность от 10 до 1000 Вт при частоте следования импульсов до 1кГц и длительностью импульсов 70-200 нс. При этом число лазерных диодов в решётке колеблется от 10 до 60.
При температуре жидкого азота в решётке из 1000 лазерных диодов получена средняя мощность 30-40 Вт. Вследствие низкой температуры КПД оказывается высоким (около нескольких десятков процентов). Импульсная мощность решётки составляла 1.5-2.5 кВт для длительности импульсов 2мкс, при частоте следования 10 кГц.
назад | оглавление | вперёд